MEMS技术自20世纪70年代末80年代初掀起第一轮商业化浪潮,其后经历了四次较大的变革。如今,除传统的应用外,推动第四轮商业化的其它应用包括一些面向射频无源元件、在硅片上制作的音频、生物和神经元探针,以及生化药品开发系统和微型药品输送系统的静态和移动器件等。
MEMS的很多应用要求与传统的电子制造不同,比如说,MEMS包含更多的工艺步骤、背面工艺、特殊金属以及晶圆键合等等。从理论上讲,将电路部分和MEMS集成在同一芯片上可以提高整个电路的性能、效率和可靠性,并降低制造和封装成本。因此,众多的研究机构将目光集中在了半导体制造中现有的CMOS、SiGe和GaAs等工艺。
提高集成度的一个主要途径是通过表面微加工方法,在微电子裸片顶部的保留区域进行MEMS结构后处理。但是必须考虑温度对前面已制造完成的微电子部分的破坏,所以对单片集成来讲,在低温下进行MEMS制造是一个关键。根据MEMS器件的结构特性,传统的多晶硅处理工艺不能用来集成MEMS器件和传统芯片。多晶硅芯片处理要求800度以上的高温,如此高的温度会损害甚至破坏MEMS结构。但SiGe工艺则使MEMS集成到标准硅基电子器件上部成为可能(图1)。
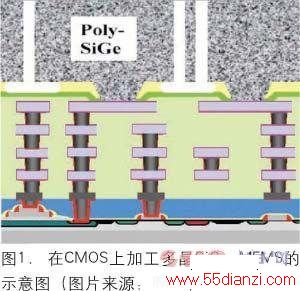
目前已开发了多种用于SiGe MEMS的工艺,主要的发展趋势是降低工艺温度或在相同温度下加快淀积速度。采用多层工艺,并结合PECVD和CVD技术,可在450℃以下的低温获得高质量的薄膜(图2),其淀积速度为100nm/min。通过调节SiH4的气体流量或增加应力补充层,SiGe层的应力或应力梯度可以进行调整。这对于在标准CMOS器件上淀积较厚的SiGe层来说非常理想。研究结果显示,Al层与SiGe间的接触是欧姆级的,满足CMOS集成的要求。
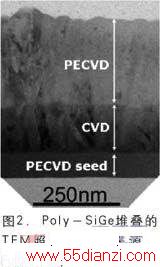
比利时IMEC开发了一种多晶SiGe淀积技术,其临界温度为450℃,而多晶硅为800℃。不过温度低时淀积速度也慢,因此又开发了第二种淀积速度更高、温度为520℃的方法。SiGe由不同Ge含量的两层组成:体层(超过65%Ge)和顶层(超过50%Ge),分别由改变淀积气体的成分得到。IMEC选择双层成分作为得到近似零应变梯度的无支撑微光镜的方法。因为层间高硅含量(上面)产生的应力由于高度压缩转变为高锗含量(体)的层间低张力,此版本结构的应变梯度可压缩顶层微调,以补偿体材料的实际应变梯度,得到超平版本的微光镜。采用CMP工艺降低表面粗糙度以提高光镜的反射率。平面化后,定型并刻蚀SiGe层以得到微光镜结构。最终的版本采用了牺牲SiO2的无粘滞蒸汽HF刻蚀。与在SiGe光镜上曝光的Al键合衬垫和可能的薄Al涂层一致。
德国博世则制造出了单芯片角速度传感器(陀螺仪)。其方案是在形成CMOS之后,再在上面形成MEMS。利用可在较低的温度下形成的poly-SiGe来形成MEMS部分,这样就不会对CMOS部分造成影响。多晶SiGe的工艺温度在400~500℃左右,远远低于已达实用水平的多晶硅所需的800℃以上。形成MEMS部分的多晶SiGe仅厚10μm,比较容易制成高精度的传感器。多晶SiGe则可在相当低的温度下提供MEMS应用所需的机械和电子特性。
SiGe对在未来的有源CMOS电路上加工MEMS来说是一项很有前途的技术。它有和多晶硅可比拟的电学和机械特性,但能在更低的温度下加工。此方法不仅适用于以上提到的情况,也可用于大量的MEMS结构的通用技术。
本文关键字:技术 传感器,电子学习 - 基础知识 - 传感器
上一篇:机器人的感觉器官-传感器