20世纪70年代随着微处理器的出现,计算机和半导体供应商逐渐认识到,集成电路需要在整个制造过程中尽可能早地进行测试,因为芯片制造缺陷率太高,不能等到系统装配好后再测试其功能是否正确,所以在IC做好之后就应对它进行测试,一般在自动测试设备上采用仿真完整系统激励和响应的功能测试方案进行。
功能测试使制造过程更加经济高效,因为可以保证装配好的电路板和系统都是由已知完好的部件构成,所以成品工作正常的可能性更高。功能测试代表了第一代IC测试,广泛应用了近二十年。随着电子产品越来越复杂专业,专用集成电路(ASIC)成为数字测试的重点,这种电路的开发周期更短,需要新的测试方法。
20世纪90年代初期,创建一套能满足缺陷覆盖率水平的功能测试方案成本非常高昂,而且开发工作单调乏味,此时扫描测试显示出明显的优势,它具有可预测覆盖范围自动测试方案生成(ATPG)功能。与集成可测性设计(DFT)合在一起,设计人员能于设计早期保证其设计是高度可测的,且满足严格的质量要求,没有过多技术性工作,也不会造成计划延迟。在过去十年,这种从功能测试到扫描测试的转变代表IC测试走向了第二代。
新型系统级芯片测试方法
如今整个系统都能放在一个芯片上,百万门SoC产生的新挑战带来了对第三代数字测试的需求。最根本的问题与经济效益有关,即设计人员和测试工程师应如何应用扫描测试,既达到可预测高覆盖率,同时制造成本低且对设计影响最小?之所以有这种要求的原因之一是如果要实现高覆盖率测试,扫描测试的数据量将急剧增长。决定扫描测试数据的因素包括:
·扫描状态元件总数
·目标故障位置总数
·被测故障模式的数量和复杂度

上述每个因素都会随新一代硅片工艺技术进步而使最后的数据量大幅增加。把这些因素与芯片I/O的数量限制和速度增长,以及ATE通道的物理约束结合起来考虑时,会发现扫描测试时间和成本都将呈指数增长。
确定性逻辑内置自测结构
Synopsys确定性逻辑内置自测(DBIST)是高级系统级芯片测试DFT Compiler SoCBIST的一个很重要的功能,是一种有效数字逻辑测试方法,能提高测试质量,减少测试对设计人员的影响。它可以降低下一代集成电路测试成本,提高未来更大更复杂SoC设计的总体质量。
SoCBIST对一次通过测试综合方案DFT Compiler进行了扩展,使设计人员在其设计中可直接实施可预测逻辑内置自测(BIST),而不会影响设计的功能、时序或电源要求。DBIST提供了一整套功能强大的BIST设计规则检测(DRC)、综合、集成、方案生成、验证及诊断能力。
图1是Synopsys确定性逻辑BIST的基本结构,它利用已有的逻辑BIST概念和技术实现下面几个基本目标:
·支持大量并行内部扫描链路,从而将测试时间缩短至少一个数量级;
·把扫描测试数据编码成BIST晶种(seed)与符号,使测试数据量减少几个数量级;
·大幅减少所需测试引脚数。
尽管可以考虑其它更简单的扫描压缩技术,但都不能像逻辑BIST那样降低整个测试成本。此外,逻辑BIST是未来测试复用和移植的理想环境,它可使为某一内核/模块开发的测试也能应用于SoC/芯片级、板级和系统级测试当中。
传统逻辑BIST解决方案已出现多年,但仍因为若干根本问题没有得到广泛的应用,包括:
·工具仍限定在设计流程,而不是一个综合解决方案;
·覆盖率取决于随机逻辑BIST,这导致不可预测的设计影响和更低的测试质量;
·测试依赖于长时间自测,相对于在昂贵的ATE上的制造测试效率很低,只能预计故障检测率;
·诊断成为事后诸葛亮,需要专用ATE接口,不能提供完整的信息确定缺陷的位置。
集成确定性逻辑BIST流程
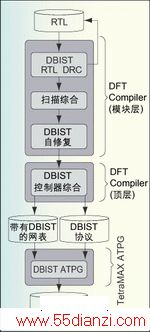
图2是DBIST流程的主要步骤,和扫描DFT相比只额外多了几步,设计或测试开发工艺中没有引入新的迭代过程。该流程的关键是一组定义明确的逻辑BIST规则,作为寄存器转移级(RTL)规则检查基础和与RTL综合集成在一起的自动化规则冲突解决机制,DFT Compiler为扫描特性提供大量支持,所以DBIST方法对于现有大多数扫描流程只需要有一些简单的增强即可。在综合模块水平上,增加的逻辑BIST规则只用于能传播X值到符号分析仪的未控制节点,在其它扫描单元完成综合后,对冲突节点提供全面的测试节点可控性;在顶层上,未连接到ATE进行DBIST测试的芯片引脚通过附加封包扫描单元对观察进行控制。与传统逻辑BIST不同的是,无需增加测试点就可提高随机方案抵抗逻辑的可控性和可观察性。
在设计顶层,DBIST控制器自动由DFT COMPILER合成、插入并连接到带DBIST的模块测试引脚上。为支持更大型设计,DFT Compiler可以使用扫描插入和带DBIST模块的“只测”模型,这些只测模型提供的容量几乎无限,大大缩短了顶级DBIST综合的运行时间。DBIST控制器几乎不需要用户输入,可自动配置用于最后内部扫描链路结构,其流程是透明的,它处于DBIST解决方案的中心并帮助得到最后的结果。
DBIST控制器利用若干标准逻辑BIST元件实现高度优化测试系统,这些单元包括:
·一个或以上伪随机方案发生器(PRPG),每个都由一个很宽的线性反馈位移寄存器(LFSR)和并行影子寄存器组成,以使晶种再植最优;
·一个或以上移相器,为内部扫描链路输入提供统计独立的PRPG值;
·一个或以上压缩器,把内部扫描链路输出数减少到1/4;
·一个或以上多输入记号寄存器(MISR)以收集测试响应;
·一个DBIST状态机和相关计数器。
除了所需逻辑BIST功能外,DBIST还支持4个单独测试模式用于完整的制造测试程序:
1. 常规DBIST测试模式——内部扫描链路数据来自于PRPG,扫描链路输出到MISR。
2. 常规扫描测试模式——内部扫描链路绕过DBIST控制器,重新设置为数量更少直接连到芯片引脚的扫描链路,该模式对于小型扫描测试很有用,如IDDQ和路径延迟方案。
3. DBIST控制器测试模式——DBIST控制器里的状态元件重新设置为直接连接到芯片引脚的扫描链,允许DBIST控制器高覆盖范围测试。
4. DBIST诊断模式——内部扫描链路数据来自于PRPG,但是扫描链路输出绕过MISR功能,这样捕捉的数据能直接卸载并在MISR输出端取样。
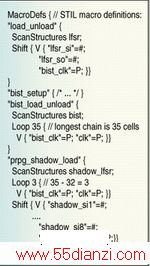
创建完整带有DBIST设计的最后一步很容易被忽视,但它与前面的步骤一样重要。在这一步中,DFT Compiler为所有DBIST控制器测试模式创建DBIST测试协议。这些协议为TetraMAX生成的DBIST方案提供全面控制和时序信息,同时要求能识别DBIST测试结构和正确实施全面的顶级DBIST DRC。图3是采用IEEE标准测试接口语言(STIL)句法做成的DBIST测试协议文本样本。
可预测高测试覆盖率
正如DFT Compiler可以确定提供带DBIST的设计一样,TetraMAX ATPG可以确定生成有效的DBIST测试方案,提供和扫描一样高的覆盖率,这样的范围只能通过赋予PRPG状态初始化外部数值才能可靠实现。和扫描测试方案一样,TetraMAX ATPG关注多种故障,并只设定所需的关注数据位(care bit)来检测这些故障。与用随机数填满剩余非关注位的扫描方案不同的是,DBIST方案的非关注位来自于PRPG,关注位用于计算PRPG晶种。
只要DBIST方案的关注位少于PRPG状态位,就能解线性方程以找到PRPG外部值,这样就能生成带有全部所需关照位集的方案。从一些用户电路收集到的数据表明,在256和512比特之间的PRPG生成方案与扫描相比覆盖范围没有缩小。与扫描一样,TetraMAX将用故障模拟PRPG生成的全部DBIST方案,反映非确定值附加测试覆盖范围。TetraMAX Verilog模拟测试台完全支持针对正常芯片模式的DBIST方案验证。
该技术不仅适用于粘着性故障测试,而且适用于确定性转换故障方案。DBIST结构允许两个没有ATE外部信号变化的全速周期,不用最后位移发射和捕捉时钟脉冲。这种试验比传统扫描或逻辑BIST试验具有更高深亚微米缺陷覆盖率,而且不会使全速逻辑BIST耗用太多功率。DBIST形成的巨大空间保证了以最少附加成本也能应用高覆盖范围转换故障方案。
本文关键字:暂无联系方式传感-检测-采集技术,电子知识资料 - 传感-检测-采集技术