ժҪ������45nm�������ٽ�����֮��Ӧ��һЩ����ȴ�����ӳ٣������ڽ���դ�� ��k���� ���� 3D�ṹ �ȡ����˹�ҵ����������ģ�������ǿǨ���ʺ�����������Ӧ�乤�̼������ڶ������ڻ������棬�������Ϸ�չ����û�г��ı����ڳĵ��ALD��Ĥ����Ҳ�����١�
������45nm�ڵ���˵������˾���Բ�ʹ�� FinFET ����k���ʺͽ���դ��Ҳδ����Ҫʹ��SOI�ĵף�����һ����ز����٣��Ǿ���Ӧ�乤�̼�������Ŀǰ�ľ���ܹ��������У�Ǩ������ǿ�������������ϵ�����ʮ�������������������������ֶ���ȶ��ԣ�������������Ľ�оƬ�������ܵ�Խ��Խ������ӡ�������������/�ྦྷ��դ�Ѵﵽ�������ܼ��ޣ����պͲ��ϵĴ����Ǵ�ʹ����ܵ�����ʵ��45nm��45nm���¼�������Ч�ֶΡ���Ȼ������Ӧ������⣬оƬ������������dz�ᡢ�͵����ʽӴ��Ͷ�㻥�������������ı仯�����Ƕ���45nm�ڵ���˵������Ӧ�乤����߷�ͷ��
����������е�IEDM�����У�AMD�����˽������Ӧ�������Ľ�NMOS��PMOS���������ķ���������һ������ͬ�����ߴ����Ӧ��������ȣ���ʹоƬ�������ٶ����40%�ķ���(ͼ1)��
�������Ľ���������45nm������Ӧ�乤�̵����½�չ����k�ͽ���դ��Ҫ�˷����ϰ����Լ���㻥���ͽӴ����̵ķ�չ��
������Ч�ȱ���С
��������դ�ij��Ȳ��ϼ�С�����ٵ�һ����ս���ڿ��ƶ̹���ЧӦ��ͬʱ���ں�����©�����±��ָ���������(Ion)��Ȼ����Ŀǰ��ҵ�ڣ���������/�ۺϹ�դ�ﵽ�˵ȱ���С�ļ��ޣ�����й©�����ĺͱ���դ�����������ЧӦ���ߴ�Ľ�һ����С�����ܴٽ����ܵ���ߡ�
��������������£����������̰�Ŀ��ת�����������ò���(��k/����դ)���ܴ����̷���(ʹ��Ӧ���)���������þ���ܽṹ����˫դ�ͳ�������SOI����Ȼ��k/����դ������о��Ѿ�ȡ���˺ܴ�Ľ�չ������Ԥ����32nm�ڵ㵽��֮ǰ����ѡ��դ�������켼����ͬ���أ�3D��������finFET���Խ���ƽ�� CMOS�����ķ�չҲ���پ������ء�Ŀǰ�����IC��������Ϊ������������Щ�����г��ֵ�ͬ��������Ӧ�乤�̴�����������������ڿ�Ԥ����δ���������� 1�г���Ӧ�乤�̺�դ���㼼���ķ�չ��ͼ��
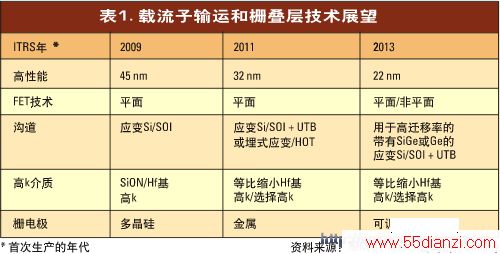
������Ȼ������ܵĵȱ���С�����������˸���Ӱ�졣����ʹ�ö��ͭ����������Ʒ��˾��˵������ʹ�ö��ַ�����֤δ��������Ʒ�ĵȱ���С�������ܣ��罫�����۵IJ��ñ�ԭ�Ӳ����ݵ�����(ALD)ȡ�������������(PVC)�ķ�����
����Ӧ���
����Ӧ�乤���漰�辧���Ӧ�似����������߹����е�������ӵ�Ǩ����(NMOSFET�еĵ��Ӻ�PMOSFET�еĿ�Ѩ)�����ַ����ĸ��������ǿ��Խ���Դ/©�Ĵ������衣ѹ��Ӧ�������PMOS����ܣ�ͨ��Ӧ����������SiGeԴ/©��/����դ��ʹ��һ��ѹ��Ӧ�䵪����㡣Ŀǰ�о����ص������ PMOSFET�У���Ϊͨ����ѨǨ���ʱȵ���Ǩ����ҪС������������NMOS�������ʹ��������Ӧ�䵪����㡣��֤ʵ��Щ���շ�����������Ժ��Լ۱ȣ���������Ӧ����90nm�ڵ�������С�
�������ڵ���ͨ��(100)�����ʱ�ٶȽϿ죬����Ѩͨ��(110)�����(�����ĵľ���)ʱ�ٶȽϿ죬�����Ļ�Ͼ�����(HOT)Ҳ��������������������Ŀǰ��Ҫ��IBM��˾������������о�����ʹ������դ�ӳ��½���20%����Ȼ���ֹ����ܸ����Ժͳɱ�����Լ������ʦ�����ڼ��乤�գ��Ӷ�������Ŀ������ԡ�
������һ�ֿ��õķ�����˫��Ӧ���ȫ��Ӧ�似���������ö��ַ���ʹ������Ƭ����Ӧ�䡣��Ϊ����ȱ�ݺͼ�������(ͼ2)�����ַ�����32nm�ڵ�֮ǰ���ܲ�����������������Ԥ�����ּ����ܹ���ijЩ����Թ��շ���(��Ҫ�ǵ���)���в��䡣
��������ǰ���ᵽ��������AMD��IBM�Լ���֥��˾�����˵�����Ӧ��輼����������NMOS�н����˫Ӧ��ĵ��Ӧ�����似��������PMOS���������� SiGe��ͼ1�Dz���SEM�õ��������Ľ���ͼ����������90nm�����ڲ��ֺľ�SOI��������ɣ����ȱ���С��65nm�������������ͼ��ɽṹ��ʹ�����SiGe����դ���ܿ������ھ����ע��֮ǰ���SiGe�����������ö���ֲ�����Լ�һ�㾭���˻��ȥ����Ӧ��ת��Ĥ������Ӧ����䵽NMOS�С�Ni���й軯��Ӧ����ѹ���ĵ棬����NMOS��ȥ����Ȼ����������ĵ棬����PMOS��ȥ�����о�����ע���Ϊ�Ľ�Ӧ����ӦǨ���ʣ�����Ͳ�������Ǩ���ʼ������������������������ͨ��NiSi�����Ż�����ʹ������Խ��ͣ�����ѹ���ĵ�������ĵ����ε������Ҳʮ����Ҫ�����ײ���˫��Ӧ����PMOS�� NMOS�������������ֱ�������53%��32%��ʹ�����ٶ������40%������Ľ��Ͷ���ȫ��ʵ��Ӧ����ĸ�������ʮ�ֱ�Ҫ���ڲ��õĽ�����ҪѰ���µķ�������Ӧ����ӦǨ���ʡ���һ��SiGeӦ��������ʹ�ø��ߵ�Ge ��������ʹդ��S/D����֮��ļ�������ܡ�
www.55dianzi.com
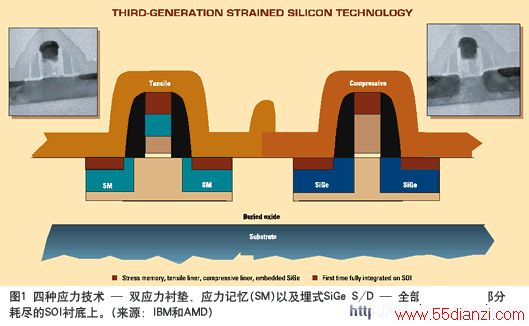
������˫Ӧ���ĵ��Ƕ��ʽSiGe���ϵ���һ�ַ����У���֥�����ṫ˾���о�����̽������Щ�����Ŀɵȱ���С�ԡ�����ʹ��ģ�ⷽ����������ܾ����������X��Yά�ȵ�Ӧ��������������£�ǡ���ڵ缫֮��Ŀ�϶����֮ǰ��X����Ĺ���Ӧ����������ֵ��Ȼ��Ѹ�ٵ��䡣Y�����Ӧ�����ź�ȵ����������ǡ���ڵ缫֮��Ŀ�϶����֮��ﵽ��ֵ����ˣ���Ӧ���ĵ漸����ȫ������ܾ����֮��Ŀ�϶ʱ��Ӧ���ṹ�ﵽ��ѡ��ڼ��������У����դ��Ϊ����������Ӧ������դ��϶�ļ�С���½���Ӧ���½�����������դ�ռ�ļ�С��SiGe��������½���Ȼ�������ڰ�����ȡ���ں�դ�߶ȵĵȱ���С������դ���ĵȱ���С��X�� Y��Ӧ���ڵȱ���С�ֲ��䡣����32nm��22nm�ڵ㣬�ٶ�ÿһ����Ʒ�ȱ���С70%����֥�����ṫ˾����ﵽ��Ӧ��ˮƽ������ģ�⡣�ܵ���˵��Ϊ��֤���ܣ�32nm��22nm�ڵ�ijĵ�Ӧ����ֱ����11%��35%��
����ͼ2��Ǩ���ʷ�չ��ͼ��������45nm����Ʒ��ʼ������HOT��ȫ�ľ�SOI�����Ͳ����Լ���դFET�����뵥��Ӧ����˫��Ӧ���������ϡ�Ȼ����ֻ������Լ۱ȵļ����Ż���ʵ�ã��ڵ���Ӧ������Ϊ��ˡ�

���� ��k����
�����ڸ�k���ʵĿ���������ȡ���˺ܴ�Ľ�չ��������HfSiON��HfO2�������ϰ����ڷ����ܼ��������⣬��������ϸߵ���ֵ��ѹ��Ǩ�����˻��ͳ���ɿ������⡣
����������Ϊ��k�����з����ܼ�������������դ���洦��Hf-Si�������Ĵ�϶̬��������λ����ġ�������о�ȡ�õ�������չ��ʹ�÷�(F)�ۻ�ȱ��λ���Ӷ����ͽ��������ܶȡ��ɲ�������ע����ڷ����в����˻ѷ����빵��������������ЧӦ�����˽������ܶȺ͵�ɵ��ݻӶ��õ��˸��õ���ֵ�ȶ��Ժ� CV����������ȥ��Ĺ��ʵ�����������(IEDM)�п��ǵļ�ƪ����������������Ӧ����ʹ�÷��ķ�����Renesas(����)���о�������֤���� 90nm�ڵ��У���SiON/�ྦྷ��ƽ̨��ȣ�����HfSiON/�ྦྷ��ƽ̨��ʹSRAM��Ԫ����ܵı仯�Եõ����ơ�
��������դ
�����ྦྷ��դ��ȫ�軯��Ӧ(FUSI)�������Dz���Ni���ѳ�Ϊ����Ӧ���аѽ���դ��CMOS�����༯�ɵļ����������ķ��������ַ��������ư������������ྦྷ��ǰ�����պ�NiSi�д�϶�������ļ����ԣ��Լ�ͨ������ע��Թ��������е�г�Ŀ����ԡ����⣬���ڹ軯��Ӧ��������Խϵ͵��¶��£���������ڽἤ��֮����С�
����Ȼ��������FUSI���ջ�����һЩ��ս�����а��������еIJ��ֽ���ȫ�軯��Ӧ���Լ�ʹFUSI��CMOS���ղ�������С��Ӱ�졣���ǣ�������ֵ�ù�ע�Ļ��ǿɵȱ���С�ԡ������˾ϣ�����k/����դ��������ת�䣬Ҳ��ֱ�����k��˫���ܽ���դ�ı䣬Ҫ������������ /FUSI(һ����ʹ�õķ���)���k/FUSI���ɣ����������k/����դת�����ȡ��
����Ȼ�����������Ĺ�˾�����о�FUSI������Ӣ�ض���˾���������NiSi FUSI���պ�Ӧ��輼������������õ��˼������ߡ��о�������35nmդ�����(Vdd=1.2V, Ioff="100" nA/�m �����£�NMOS Idsat="1".75 mA/�m, PMOS Idsat="1".06 mA/�m)��ʵ����ǰ��δ�еĸ�����������Ӣ�ض���˾��Pushkar Ranade����ͬ�������ǵ������в�����FUSI���������ھ�ȷ�Ĺ����Ż�����ֵ��ע����ǣ�NiSi�IJ���ȫ�γɻ�����γɶ����������ԵIJ����仯��Vt�ı仯���ܱ�����Ϊ��դ�������ı仯����ͨ��NMOS ʱ����ؽ��ʻ���(TDDB) ��PMOS��ƫ���¶Ȳ��ȶ���(NBTI)��õ�FUSI�����Ĺؼ����⣬�������Ŀɿ��ԣ�������ƾ�Բ����������FUSI�����У�Ӧ�ֱ��趨p��n�����������봫ͳ��CMOS��һ������Ȼ�����ڹ軯��Ӧ֮ǰ�Զྦྷ����в��ӣ�IMEC��˾���о�������֤��ͨ��ʹ�ò�ͬ��NiSi״̬(����NMOS�� NiSi������PMOS�ĸ�Ni NiSi)���ɻ����Ӧ��P/NMOS����������ֵ��ѹ������ʹ����(Yb)���Ӷ�NMOS-FET�Ĺ��������е�г�����ڹ軯��Ӧ���е�խ�߿�ЧӦ�����ֹ��յĹؼ����ڿ��������߿���Ni:Si��ȵ���Ч�ȡ��ڽ���դ�軯��Ӧ֮ǰ������һ�֡�ѡ��ྦྷ���ʴ������ʹPMOS������Si�ĺ���½���Ҫ�Բ�ڳĵ�֮��������軯��Ӧ�������ơ�����IMEC��˾�ı������Ķ����軯���տɽ����Ni NiSi���������Ӧ������ά���Ϳ�λ����ع��ճ�Ʒ�����⡣
���Ĺؼ��֣����� �ۺ�-��������Ƭ��-�����豸 - �ۺ�-����
��һƪ��IC�ذ��Ʒ����