GE 和 LOCkheed Martin 等公司合作开发的基于HTCC基板的薄膜多层电路的T/R组件(7),如图7所示。预先将HTCC基板开槽并金属化,将功率芯片贴装预槽内,使之与基板表面持平,然后在其上实施HDI工艺。

采用 HTCC做T/R组件的基板,是充分利用了高温共烧陶瓷(HTCC)和薄膜多层的优点,而又避开其不足。HTCC的优点是热导率高、易实现多层;其缺点是由于采用的电阻率高的Mo、W等浆料制作导带,微波损耗较大。薄膜多层互连技术的优点:线条精度高,采用Cu、Au等电阻率低的材料作导带,微波损耗小;其缺点是耐功率不足、多层成本高。基于 HTCC的薄膜多层互连技术可以将电源线、地层、信号线布在HTCC中, 以满足耐功率需要并减少薄膜多层层数。功率芯片可以通过焊接的方式贴在HTCC的凹腔中,有利于散热。微带线及芯片精细互连线可以作在少数几层HDI层中,满足微波性能的需要。
3.7 LTCC基板上薄膜集成 T/R组件
Reinhardt MICrotech公司和Micro SystEMS Engineering 公司合作开发了一种可用于X波段T/R组件的精细混合(Finebrid)集成技术,这种技术是将LTCC和薄膜技术集成在一起,在采用杜邦951或943生瓷制造的LTCC板上,不用抛光等处理,直接制造精细薄膜电路图形,结构示意图见图8。利用LTCC容易实现多层的特点,把直流电源线、控制信号线做在不同的层上,还可埋置电阻、电容等无源器件。选用杜邦951或943生瓷,是因为制成的LTCC损耗比较小。利用薄膜的高精度特点,把无源器件(如Lange耦合器、滤波器、电阻网络、衰减器、功率分配器等)集成在LTCC表面。实用中薄膜图形典型的线条及间距20微米,膜层厚度5微米;NiCr层充当电阻层和粘附层。从结构图上可以看出,芯片安装在LTCC表面的凹腔内,可以减小键合长度及关联电感,芯片热量可通过背面的散热通孔柱传到下面的热沉上,可克服LTCC热导率低的缺点。经可靠性测试,在LTCC表面实施薄膜工艺与在氧化铝陶瓷上的可靠性相当。
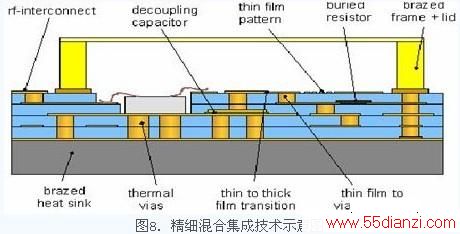
4. 结语
从以上分析可以看出,与传统的在陶瓷基板实施薄膜工艺相比,薄膜技术在T/R组件的应用有两个明显的新的趋势,一是,在高导热的金属、合金、复合材料( Al/SiC)上采用多层薄膜工艺,制造T/R组件,提高了组件耐功率性能,并且利于封装;还可根据设计需要把芯片贴装在表面的凹腔内,减短了金丝键合的长度或者不用键合,减小了或克服了寄生效应,改善组件性能;二是在其他多层基板(如HTCC或LTCC)上,实施薄膜工艺制造T/R组件,充分发挥HTCC或LTCC易实现多层及埋置无源器件的优点以及薄膜工艺高精度、低损耗的优点,对减小T/R组件基板尺寸、改善组件的电性能和热性能有重要意义。
国内,在T/R组件的制造领域,尚未见相关应用报导,可加以重视,开展相关跟进研究工作。
本文关键字:技术 布线-制版技术,电子学习 - 布线-制版技术